DRY ETCHER
Hole Pattern
Cross-view of MESA etching
Silicon 20nm Silp Line Etching










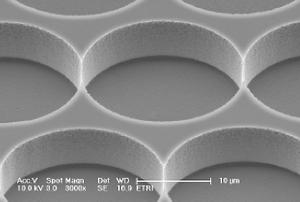
Cross-view of Poly Silicon Etching



Cross-view of Silicon Etching
Trench Pattern




PERI - R Series
SPECIFICATIONS
-
Application : Metal & Dielectric material etching
-
Etching material : SiO2, Si3N4, Si, Al, GaN, HfO2, Al2O3,Graphene,…
-
Substrate size : Piece ~ 12inch
-
Product yield : 1(one) wafer/run
-
Source(gas) injection type : Dual patterned showerhead type
-
Power supply : RF power Max. 2Kw@13.56MHz (with RF matching network)
-
Ultimate pressure : < 5.0E-3 Torr
-
Pressure control : Auto pressure control (throttle valve, baratron gauge)
-
Gas delivery : SF6, CHF3, CF4, C4F8, BCl3,Cl2O2, Ar, He,…
-
Vacuum pump : Dry pump or Rotary pump
-
Control : PC control (UPRO software)
-
Option : TMP, Loadlock chamber
-
System dimension (W*D*H) : 800mm X 880mm X 1,200mm

PERI - L SERIES
SPECIFICATIONS
-
Application : Metal & Dielectric material etching
-
Etching material : SiO2, Si3N4, Si, Al, GaN, HfO2, Al2O3,Graphene,…
-
Substrate size : Piece ~ 12inch
-
Product yield : 15 wafers/run
-
Source(gas) injection type : Dual patterned showerhead type
-
Power supply : RF power Max. 2Kw@13.56MHz (with RF matching network)
-
Ultimate pressure : < 5.0E-3 Torr
-
Pressure control : Auto pressure control (throttle valve, baratron gauge)
-
Gas delivery : SF6, CHF3, CF4, C4F8, BCl3,Cl2O2, Ar, He,…
-
Vacuum pump : Dry pump or Rotary pump
-
Control : PC control (UPRO software)
-
Option : TMP, Loadlock chamber

PERI - ICP SERIES
SPECIFICATIONS
-
Etching material : Metal & Dielectric material etching
-
Substrate size : Max. 8inch
-
Product yield : 1(one) wafer/run
-
Source(gas) injection type : Showerhead type
-
Chuck Unit : Chuck cooling by chiller
Substrate back side He cooling
Mechanical wafer chucking with clamp -
Power supply : Bias : RF power Max.2kW@13.56MHz
ICP source : RF power Max.3kW@13.56MHz -
Ultimate pressure : < 5.0E-6 Torr (TMP & Dry pump)
-
Pressure control : Pendulum valve, baratron gauge
-
Gas delivery : SF6, CHF3, CF4, C4F8, BCl3,Cl2O2, Ar, He,…
-
Control : PC control (UPRO software)
-
Option : TMP, Loadlock chamber
-
System dimension (W*D*H) : 2,050mm X 800mm X 1,600mm
